產品信息
特點
頭部集成了薄膜厚度測量所需功能
通過顯微光譜法測量高精度絕對反射率(多層膜厚度,光學常數)
1點1秒高速測量
顯微分光下廣范圍的光學系統(紫外至近紅外)
區域傳感器的安全機制
易于分析向導,初學者也能夠進行光學常數分析
獨立測量頭對應各種inline客制化需求
支持各種自定義
| OPTM-A1 | OPTM-A2 | OPTM-A3 |
|---|
| 波長范圍 | 230 ~ 800 nm | 360 ~ 1100 nm | 900 ~ 1600 nm |
|---|
| 膜厚范圍 | 1nm ~ 35μm | 7nm ~ 49μm | 16nm ~ 92μm |
|---|
| 測定時間 | 1秒 / 1點 |
|---|
| 光斑大小 | 10μm (最小約5μm) |
|---|
| 感光元件 | CCD | InGaAs |
|---|
| 光源規格 | 氘燈+鹵素燈 | 鹵素燈 |
|---|
| 電源規格 | AC100V±10V 750VA(自動樣品臺規格) |
|---|
| 尺寸 | 555(W) × 537(D) × 568(H) mm (自動樣品臺規格之主體部分) |
|---|
| 重量 | 約 55kg(自動樣品臺規格之主體部分) |
|---|
測量項目:
絕對反射率測量
多層膜解析
光學常數分析(n:折射率,k:消光系數)
測量示例:
SiO 2 SiN [FE-0002]的膜厚測量
����半導體晶體管通過控制電流的導通狀態來發送信號,但是為了防止電流泄漏和另一個晶體管的電流流過任意路徑,有必要隔離晶體管,埋入絕緣膜。 SiO 2(二氧化硅)或SiN(氮化硅)可用于絕緣膜。 SiO 2用作絕緣膜,而SiN用作具有比SiO 2更高的介電常數的絕緣膜,或是作為通過CMP去除SiO 2的不必要的阻擋層。之后SiN也被去除。 為了絕緣膜的性能和精確的工藝控制,有必要測量這些膜厚度。

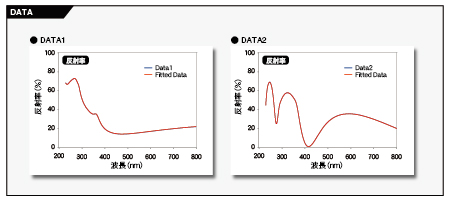

彩色抗蝕劑(RGB)的薄膜厚度測量[FE - 0003]
������液晶顯示器的結構通常如右圖所示。 CF在一個像素中具有RGB,并且它是非常精細的微小圖案。 在CF膜形成方法中,主流是采用應用在玻璃的整個表面上涂覆基于顏料的彩色抗蝕劑,通過光刻對其進行曝光和顯影,并且在每個RGB處僅留下圖案化的部分的工藝。 在這種情況下,如果彩色抗蝕劑的厚度不恒定,將導致圖案變形和作為濾色器導致顏色變化,因此管理膜厚度值很重要。


硬涂層膜厚度的測量[FE-0004]
�����近年來,使用具有各種功能的高性能薄膜的產品被廣泛使用,并且根據應用不同,還需要提供具有諸如摩擦阻力,抗沖擊性,耐熱性,薄膜表面的耐化學性等性能的保護薄膜。通常保護膜層是使用形成的硬涂層(HC)膜,但是根據HC膜的厚度不同,可能出現不起保護膜的作用,膜中發生翹曲,或者外觀不均勻和變形等不良。 因此,管理HC層的膜厚值很有必要。
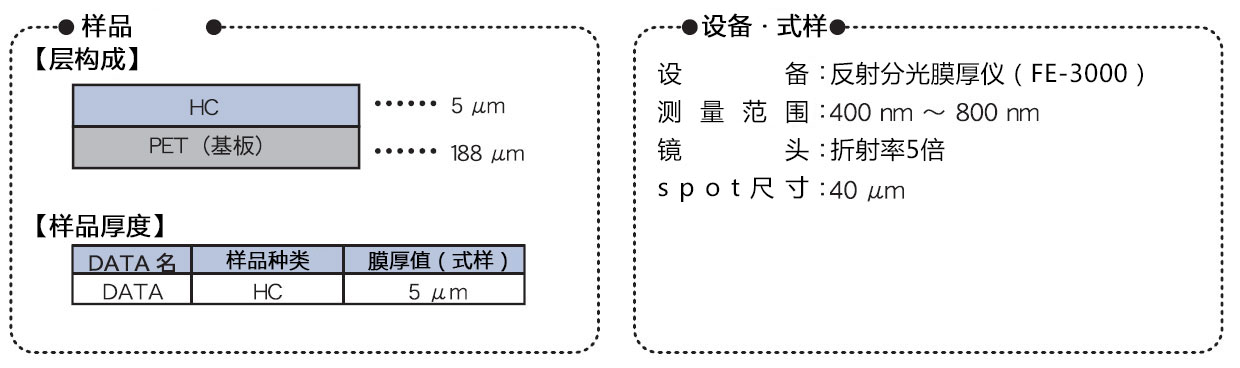

考慮到表面粗糙度測量的膜厚值[FE-0007]
�����當樣品表面存在粗糙度(粗糙度)時,將表面粗糙度和空氣(air)及膜厚材料以1:1的比例混合,模擬為“粗糙層”,可以分析粗糙度和膜厚度。此處示例了測量表面粗糙度為幾nm的SiN(氮化硅)的情況。


使用超晶格模型測量干涉濾波器[FE-0009]
�����當樣品表面存在粗糙度(粗糙度)時,將表面粗糙度和空氣(air)及膜厚材料以1:1的比例混合,模擬為“粗糙層”,可以分析粗糙度和膜厚度。此處示例了測量表面粗糙度為幾nm的SiN(氮化硅)的情況。
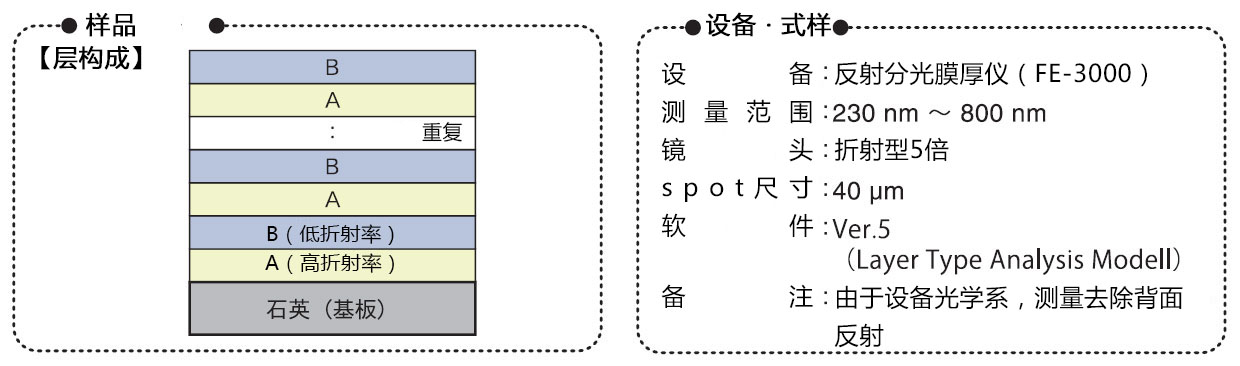
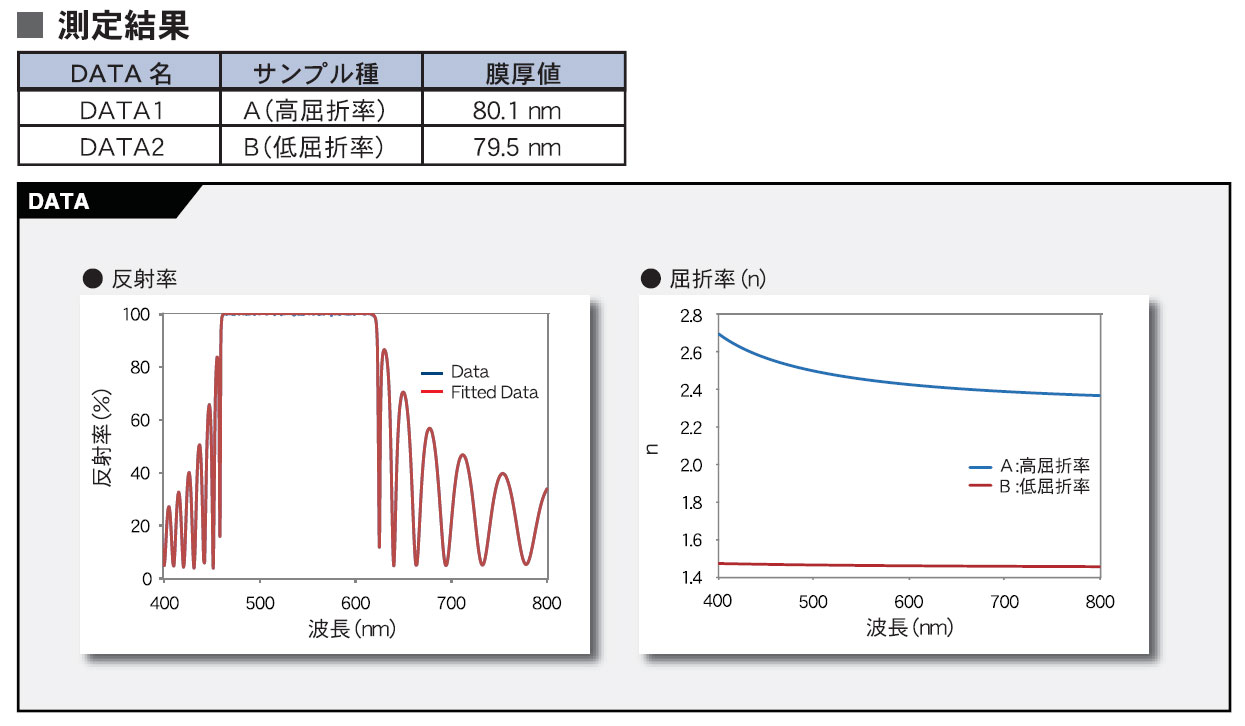
使用非干涉層模型測量封裝的有機EL材料[FE - 0010]
����有機EL材料易受氧氣和水分的影響,并且在正常大氣條件下它們可能會發生變質和損壞。 因此,在成膜后需立即用玻璃密封。 此處展示了密封狀態下通過玻璃測量膜厚度的情況。玻璃和中間空氣層使用非干涉層模型。


使用多點相同分析測量未知的超薄nk [FE-0013]
����為了通過擬合最小二乘法來分析膜厚度值(d)需要材料nk。 如果nk未知,則d和nk都被分析為可變參數。 然而,在d為100nm或更小的超薄膜的情況下,d和nk是無法分離的,因此精度將降低并且將無法求出精確的d。 在這種情況下,測量不同d的多個樣本,假設nk是相同的,并進行同時分析(多點相同分析), 則可以高精度、精確地求出nk和d。
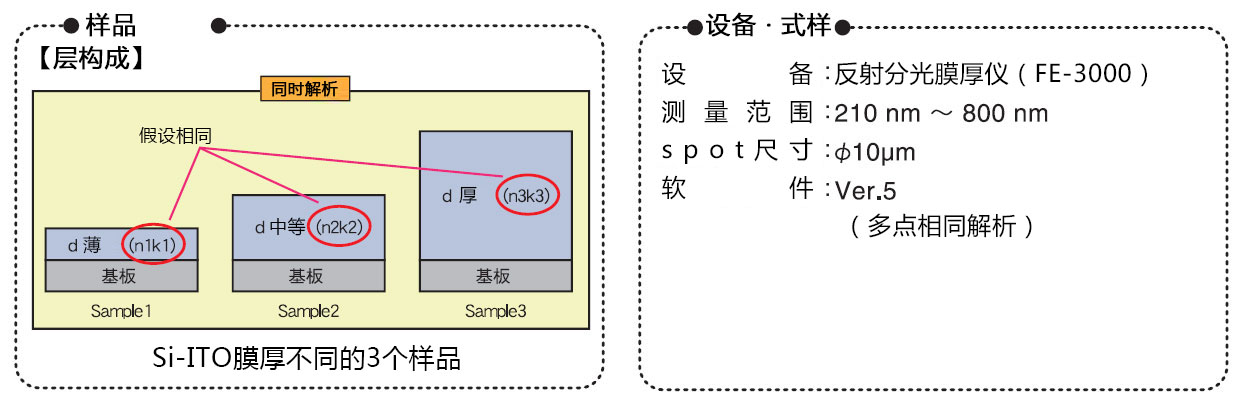
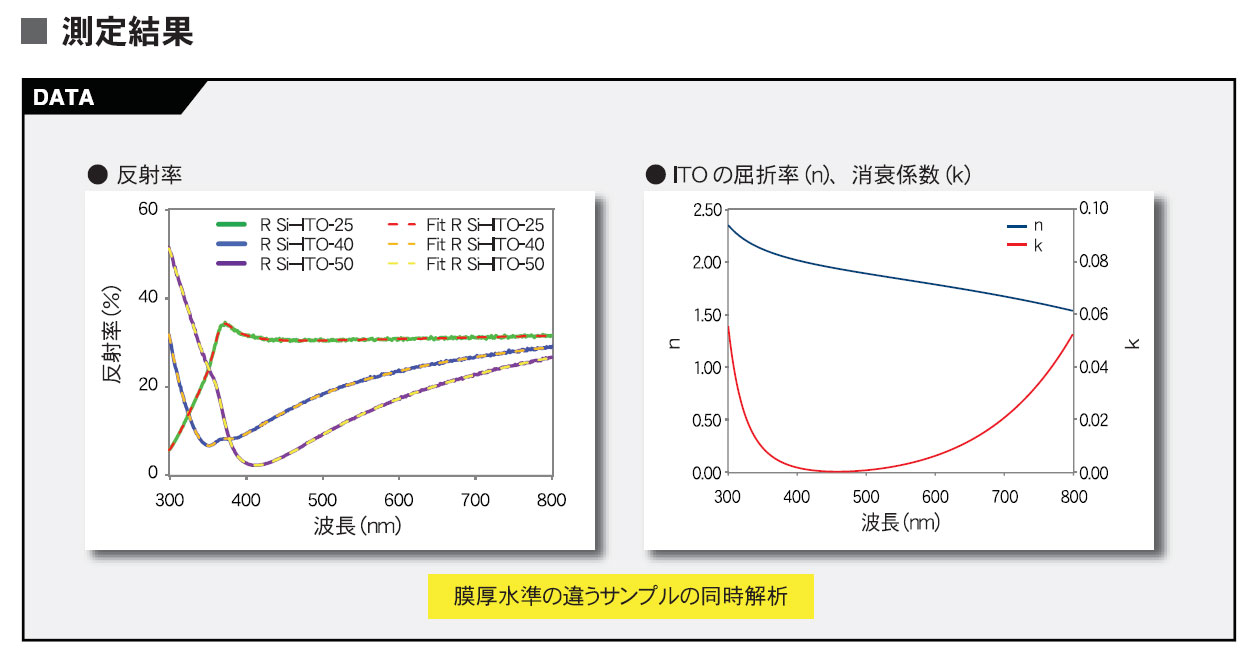
用界面系數測量基板的薄膜厚度[FE-0015]
������如果基板表面非鏡面且粗糙度大,則由于散射,測量光降低且測量的反射率低于實際值。而通過使用界面系數,因為考慮到了基板表面上的反射率的降低,可以測量出基板上薄膜的膜厚度值。 作為示例,展示測量發絲成品鋁基板上的樹脂膜的膜厚度的例子。
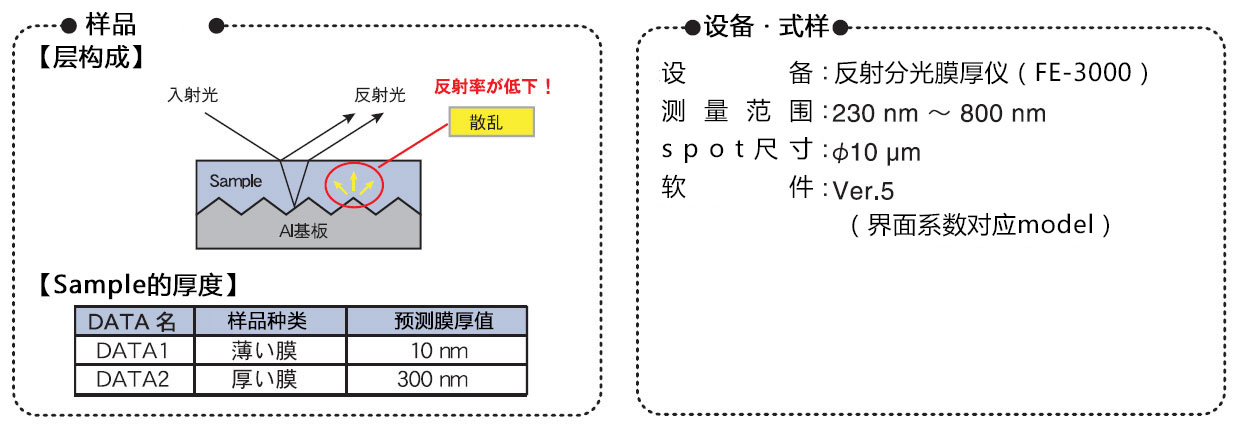
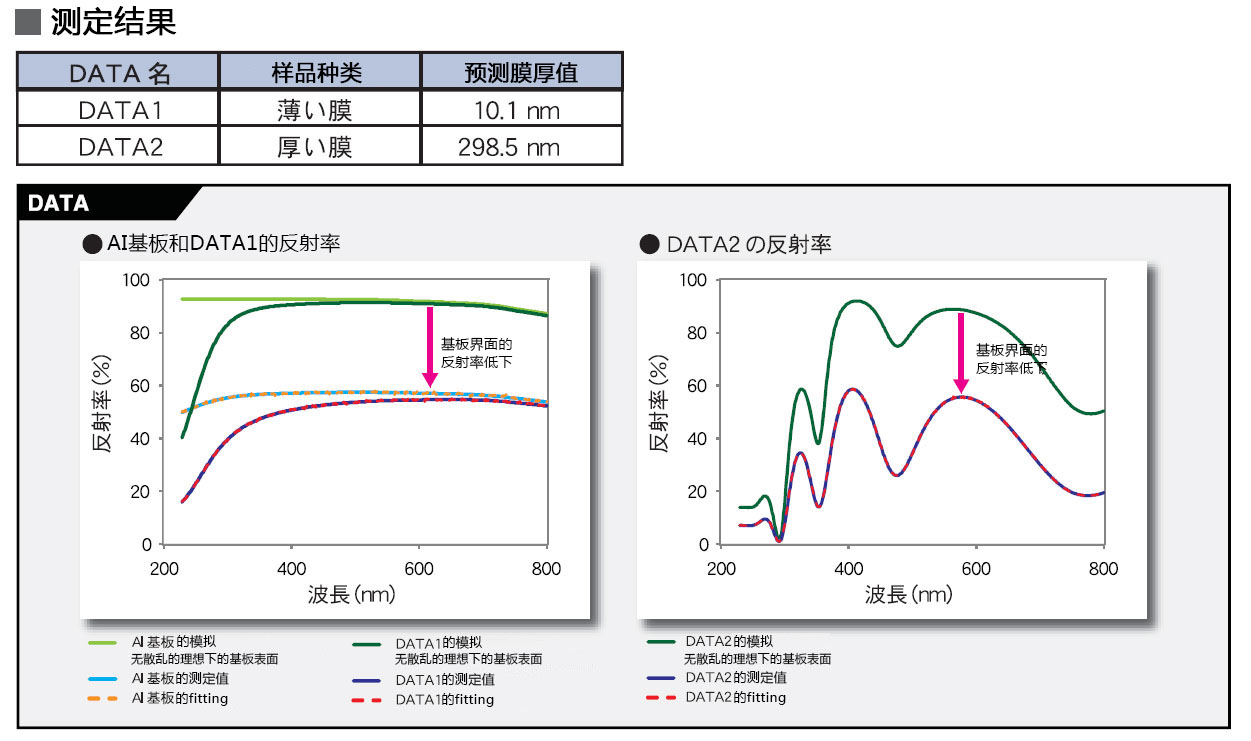
各種用途的DLC涂層厚度的測量
�����DLC(類金剛石碳)是無定形碳基材料。 由于其高硬度、低摩擦系數、耐磨性、電絕緣性、高阻隔性、表面改性以及與其他材料的親和性等特征,被廣泛用于各種用途。 近年來,根據各種不同的應用,膜厚度測量的需求也在增加。
������一般做法是通過使用電子顯微鏡觀察準備的監測樣品橫截面來進行破壞性的DLC厚度測量。而大塚電子采用的光干涉型膜厚計,則可以非破壞性地和高速地進行測量。通過改變測量波長范圍,還可以測量從極薄膜到超厚膜的廣范圍的膜厚度。
����通過采用我們自己的顯微鏡光學系統,不僅可以測量監測樣品,還可以測量有形狀的樣品。 此外,監視器一邊確認檢查測量位置一邊進行測量的方式,還可以用于分析異常原因。
支持定制的傾斜/旋轉平臺,可對應各種形狀。可以測量實際樣本的任意多處位置。
光學干涉膜厚度系統的薄弱點是在不知道材料的光學常數(nk)的情況下,無法進行精確的膜厚度測量,對此大塚電子通過使用獨特的分析方法來確認:多點分析。通過同時分析事先準備的厚度不同的樣品即可測量。與傳統測量方法相比,可以獲得極高精度的nk。
通過NIST(美國國家標準與技術研究院)認證的標準樣品進行校準,保證了可追溯性。